-
ドライエッチング装置

概要
最大φ12インチ基板を全自動で連続処理することが可能な量産装置です。
ガス種およびプラズマモードの切り替えによりエッチング、アッシング及びイオンクリーニングを可能とする汎用性に優れた装置です。特徴
- RIEモードとDPモードの切り替えが可能
- 特殊表面処理によるメタルコンタミ低減
- 省フットプリント
- 2周波独立印加方式
- 超低温冷却ステージ
用途
- 半導体
- MEMS
- 電子部品
仕様
サイズ 最大φ12インチ プラズマソース CCP型 真空排気 低真空プロセス:MBP+DP
高真空プロセス:TMP+DP圧力制御 APC制御 プロセスガス F系、Cl2、Ar、O2、他 制御操作 制御:PLC
操作:タッチパネルまたはPCデータロギング 外部メモリまたはPC 基板搬送 大気または真空搬送ロボット オプション 2周波独立印加方式
超低温冷却ステージ
静電チャックステージ
メカチャックステージ
発光分析システム
ガス検知器
シリンダーキャビネット など -
XeF2エッチング装置
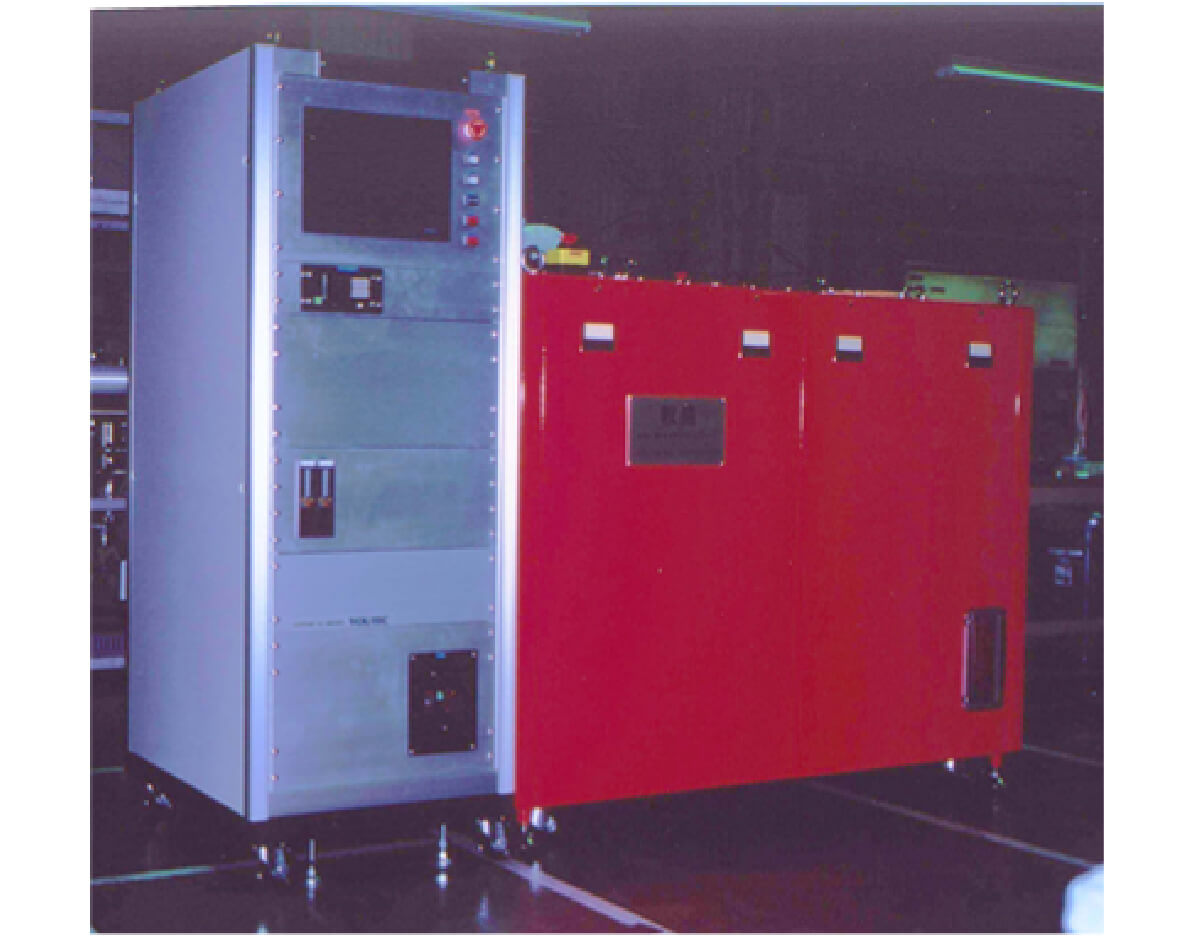
-
ICPプラズマエッチング装置

-
研究開発用ICPエッチング装置
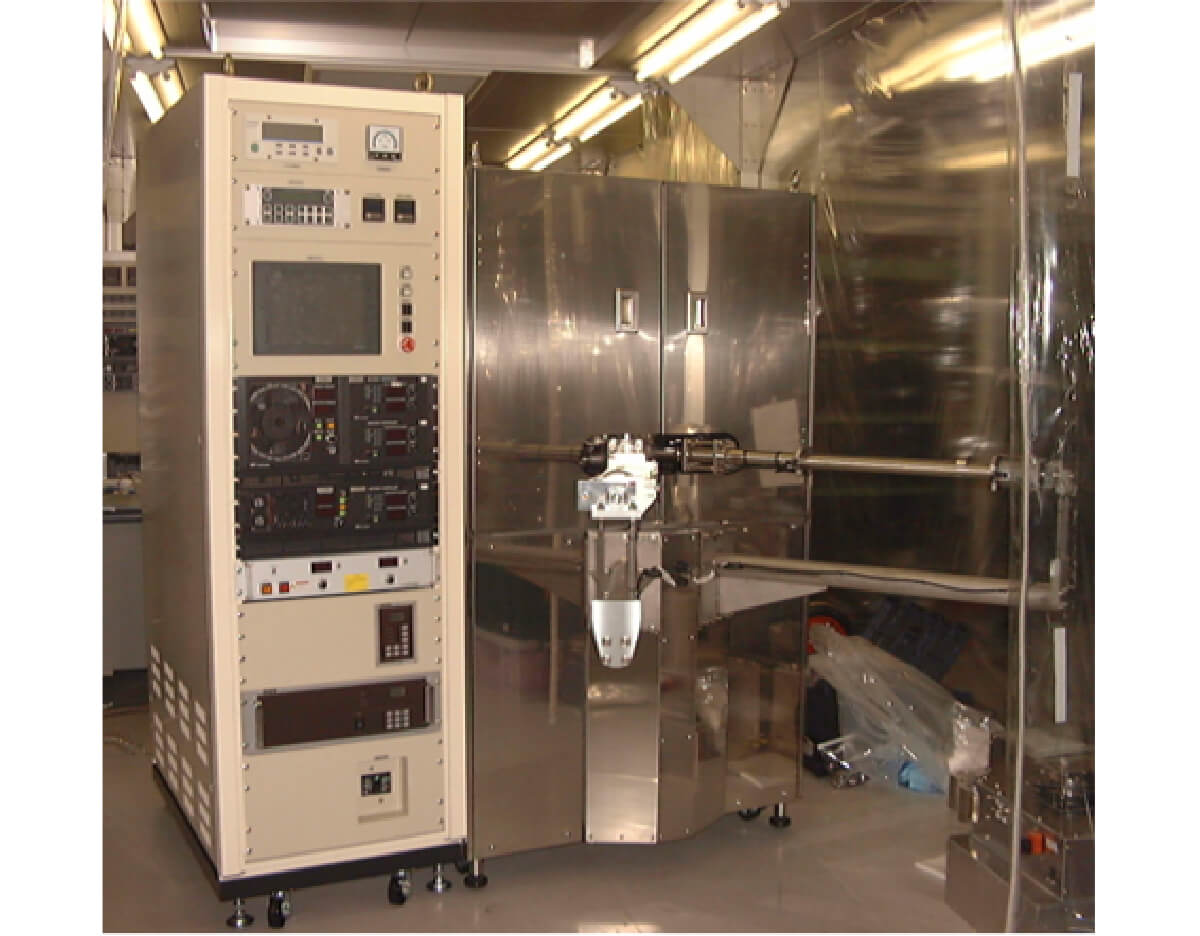
-
バッチ式アッシング装置