-
Dry Etching System

Features
It is a fully automatic mass production system that can continuously process substrates up to φ12 inch.
It is also a versatile system that enables etching, ashing, and ion cleaning by switching gas types and plasma modes.Features
- RIE mode and DP mode can be selected
- Reduction of metal contamination by special surface treatment
- Small footprint
- Double frequency independent application method
- Ultra low temperature cooling stage
Applications
- Semiconductor
- MEMS
- Electronic Components
Specification
Size φ12 inch maximum Plasma Source CCP type Vacuum Exhaust Low vacuum process: MBP+DP
High vacuum process: TMP+DPPressure Control APC Process Gas Various fluorine gases,Cl2, Ar, O2, etc. Control Operation Control: PLC
Operation: Touch panel or PCData Logging External memory or PC Substrate Transfer Atmospheric or vacuum transfer robot Option Double frequency independent application method
Ultra low temperature cooling stage
Electrostatic chuck stage
Mechanical chuck stage
Plasma emission monitor
Gas detector
Cylinder cabinet and more -
XeF2 Etching System
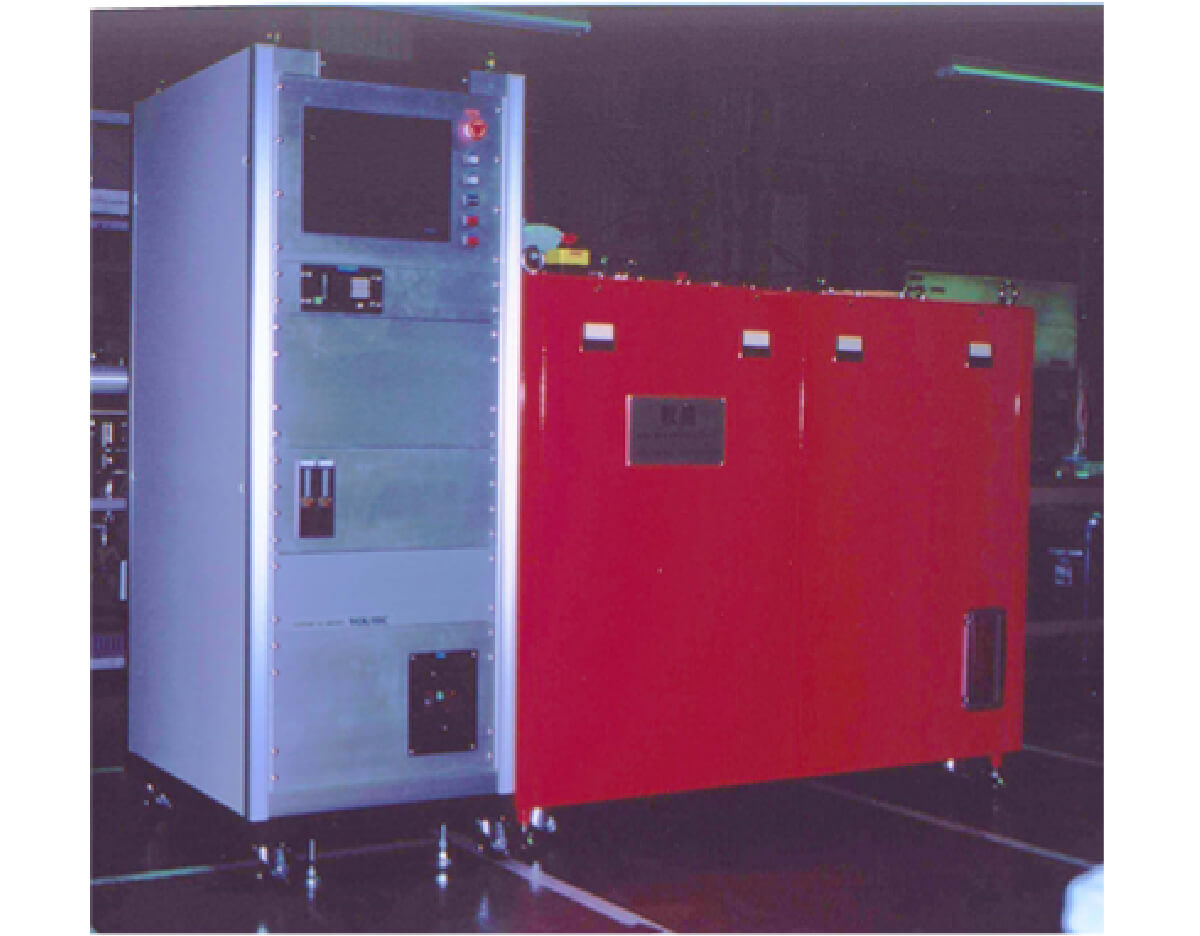
-
ICP Plasma Etching System

-
ICP Etching System for Research and Development
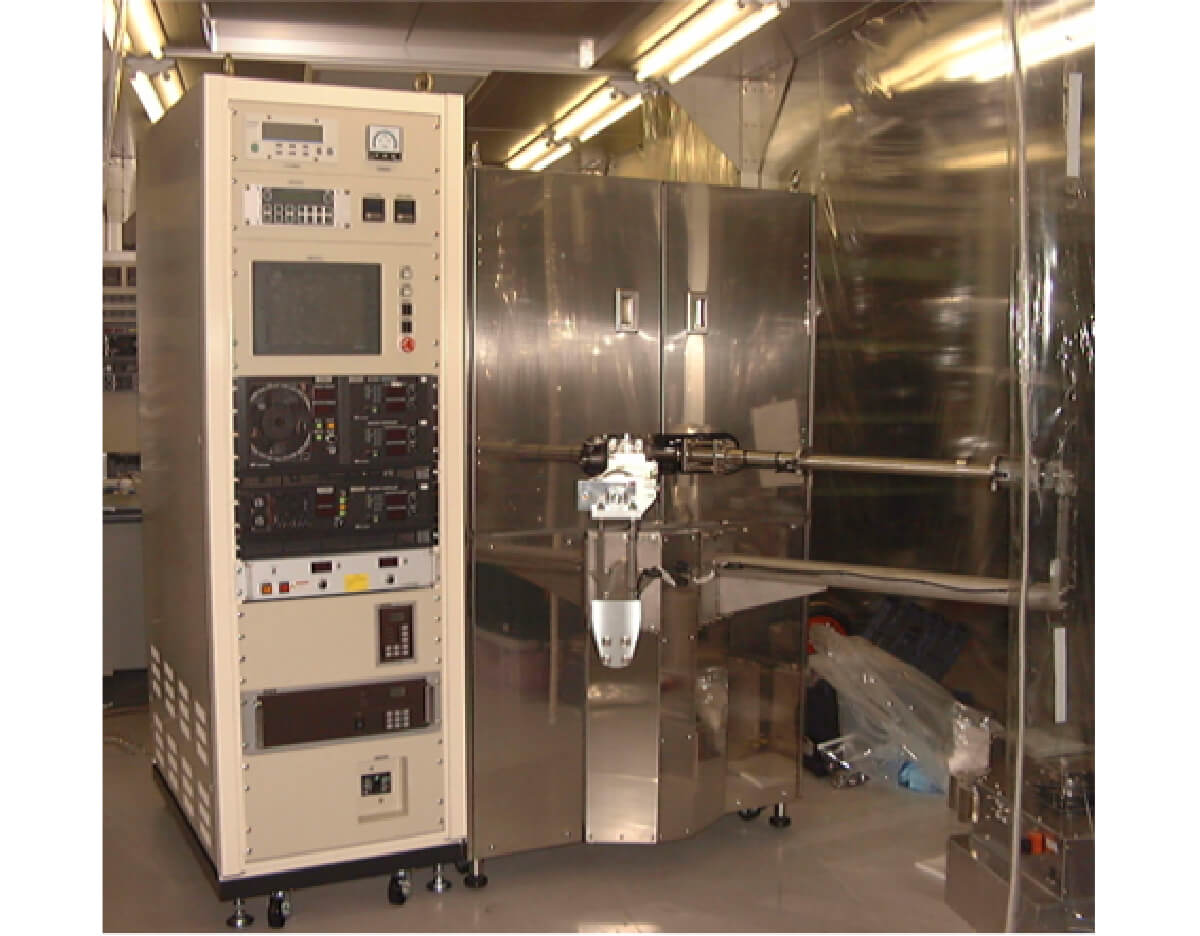
-
Batch Type Ashing System